嘉峪检测网 2025-04-28 08:28
导读:在半导体制造领域,前端工艺(FEOL)是构建晶体管结构的关键环节,而刻蚀技术作为 FEOL 中的核心工艺之一,对半导体器件的性能和制造精度起着至关重要的作用。
在半导体制造领域,前端工艺(FEOL)是构建晶体管结构的关键环节,而刻蚀技术作为 FEOL 中的核心工艺之一,对半导体器件的性能和制造精度起着至关重要的作用。
刻蚀工艺概述
刻蚀是指在半导体制造过程中,通过化学或物理的方法,将涂覆在硅片表面的光刻胶图案转移到底层的材料上,从而实现对硅片表面材料的选择性去除。其主要目的包括:形成器件的有源区、定义晶体管的栅极结构、实现源极和漏极区域的精确布局等。
刻蚀技术的分类

湿法刻蚀
湿法刻蚀是利用化学溶液与硅片表面材料发生化学反应来实现刻蚀的。它具有成本低、工艺设备相对简单等优点。例如,利用氢氟酸(HF)溶液可以有效地刻蚀二氧化硅(SiO₂)。然而,湿法刻蚀存在各向同性的问题,即刻蚀过程在各个方向上同时进行,这会导致刻蚀出的图形边缘不够陡峭,难以满足高精度、微小尺寸器件制造的要求,且可能对光刻胶的图案产生一定程度的破坏,影响后续工艺的准确性。
干法刻蚀
干法刻蚀是目前半导体制造中应用更为广泛的刻蚀技术。它主要利用等离子体(Plasma)中的高能粒子与硅片表面材料发生物理或化学相互作用,实现材料的去除。
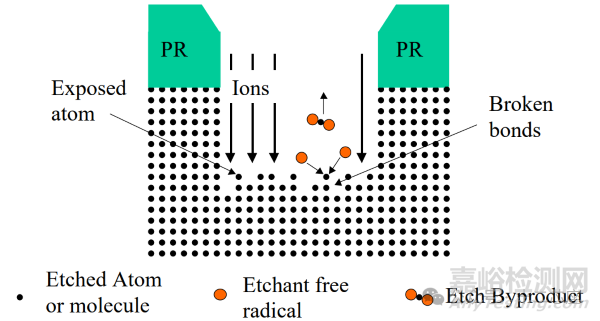
物理刻蚀(如离子束刻蚀) :依靠高能离子束直接轰击硅片表面,将材料原子从表面打出。这种方法具有各向异性刻蚀的特点,能够实现较陡峭的图形边缘。但是,由于高能离子束的能量较高,容易对硅片表面造成损伤,且刻蚀速率相对较慢。
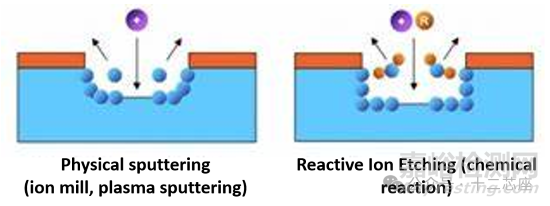
化学刻蚀(如反应离子刻蚀) :利用等离子体中的活性化学物种与硅片表面材料发生化学反应生成气态产物,从而实现刻蚀。通过选择合适的反应气体,可以实现对特定材料的选择性刻蚀。同时,它能够在一定程度上控制刻蚀的各向异性程度,兼有化学反应的高选择性和物理轰击的各向异性特点。
刻蚀工艺的关键参数和控制
1.选择比
选择比是衡量刻蚀工艺精准度的核心指标。理想状态下,我们希望只刻蚀目标材料,而不 ETCH 其他部分。然而实际上,不可能100%只刻蚀到想移除的部分,这意味着完全精准的刻蚀是难以实现的。选择性是不同材料的蚀刻率之比。
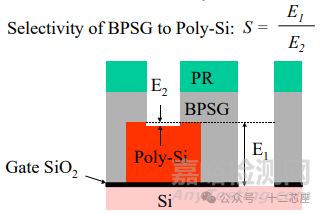
高选择比的刻蚀工艺能够最大程度地减少对非目标材料的刻蚀,确保刻蚀过程的高度精准性。选择比的高低直接关系到器件图案的完整性和准确性。如果选择比过低,可能会导致非目标区域的材料被过度刻蚀,进而影响器件的性能和可靠性。
2.方向的选择性
方向的选择性决定了刻蚀的形状和精度。它主要分为等向性刻蚀(各向同性)和非等向性刻蚀(各向异性)两种类型。
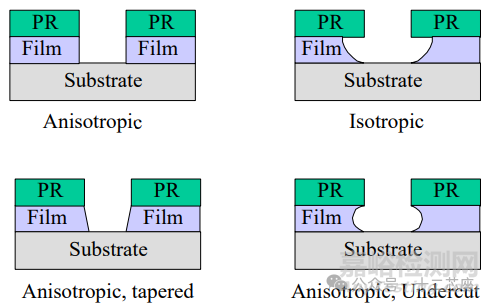
等向性蚀刻表示横向和纵向之蚀刻率相同,在刻蚀过程中,不仅会发生纵向反应,横向反应也会同时进行。
非等向性蚀刻则为横向性蚀刻率很慢或为0,因此可以较完美调控蚀刻截面轮廓和线宽,这种刻蚀方式能够实现更精细、更陡峭的图形边缘,有助于提高器件的性能和集成度。
3.蚀刻率
刻蚀速率是衡量刻蚀效率的关键参数。在其他条件保持不变的情况下,刻蚀速率越快,生产效率越高。然而,通常很难找到一个既快又精准的刻蚀方案。在工艺研发过程中,往往需要在刻蚀速率与其他参数(如方向的选择性和均匀性)之间进行权衡。例如,为了提高刻蚀的非等向性,可能需要降低刻蚀气体的压力。但降低压力会导致参与反应的气体量减少,从而使得刻蚀速率变慢。这种Balance需要在实际操作中根据具体需求和工艺条件,找到一个相对平衡的点,以实现高效的刻蚀。
4.均匀性
均匀性是评估刻蚀工艺质量的重要参数。它反映了刻蚀工艺在整个晶圆表面的刻蚀能力是否一致,以及刻蚀的不均匀程度。由于刻蚀过程中需要将整个晶圆暴露在刻蚀气体中,并且在施加反应气体后需要去除副产物并不断循环物质,因此很难保证晶圆的每个角落都得到完全相同的刻蚀效果。

这就会导致晶圆不同部位出现不同的刻蚀速率。均匀性不佳可能会引起晶圆上不同位置的器件性能出现差异,进而影响芯片的整体性能和可靠性。
刻蚀工艺的应用
1. 有源区的定义
2. 栅极结构的形成
3. 源极和漏极区域的刻蚀
4. 接触孔的形成
5. DRAM 高深宽比电容等等
为了精确控制刻蚀工艺的关键参数,需要采用先进的工艺监测和控制技术,如光学发射光谱监测(OES)、终点检测(Endpoint Detection,EPD)等。通过实时监测刻蚀过程中等离子体的光学发射光谱或硅片表面的反射信号等,可以及时判断刻蚀是否达到预定目标,并对刻蚀工艺参数进行动态调整,以确保刻蚀过程的稳定性和重复性。
Reference:
1.Semiconductor Devices: Physics and Technology.
2.Skhynix.
3.Introduction to Semiconductor Manufacturing Technology.

来源:十二芯座
关键词: 半导体