嘉峪检测网 2025-05-07 08:33
导读:本文介绍了原子层沉积(ALD)薄膜制备技术。
一、常见薄膜生长技术介绍
(1)CVD薄膜技术
CVD 技术是一种在真空环境中通过衬底表面化学反应来进行薄膜生长的过程,较短的工艺时间以及所制备薄膜的高致密性,使 CVD 技术被越来越多地应用于薄膜封装工艺中无机阻挡层的制备。
(2)PECVD薄膜技术
等离子增强型化学气相沉积(Plasma Enhanced Chemical Vapor Deposition, PECVD)利用等离子体来弥补由反应前驱体或工艺温度所带来的低反应活性问题,该工艺使薄膜气相生长过程不再受到工艺温度的局限,实现了低工艺温度下薄膜的高质量生长过程。

(3)原子层沉积技术
与 CVD 技术类似,原子层沉积(Atomic layer deposition, ALD)也是一种基于衬底表面化学反应的薄膜制备技术,除了相似的薄膜生长条件,部分前驱体材料也通用于两种工艺之间。
不同的是,CVD 技术是维持两种前驱体材料共存于真空反应腔体内,在衬底表面发生化学吸附从而形成薄膜。而 ALD 技术所建立的表面化学反应是每一种前驱体材料独立、交替发生的,每种前驱体材料均具有自限制反应特性,所对应的自限制表面半反应将物质以单原子层的形式逐层生长于衬底表面,连续的自限制表面反应满足了薄膜生长过程中的单原子层控制和共形沉积的需求。
ALD 技术的表面反应过程具有连续、自限制特性,如下图所示。
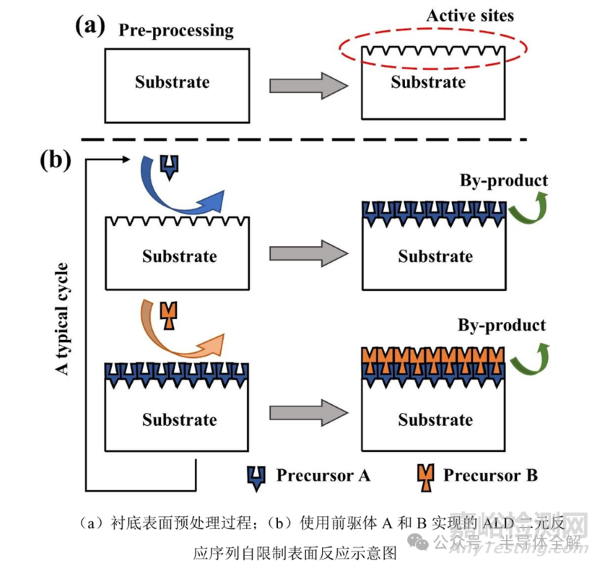
典型的 ALD 过程往往采用二元反应序列来进行薄膜生长,两种前驱体在衬底表面顺次完成各自所对应的半反应,以实现一种二元化合物膜的单层沉积过程。衬底表面的活性位点是 ALD 薄膜生长的基础,因此,在薄膜生长工艺开始之前,衬底往往会通过一些表面预处理的手段来引入活性位点或增加活性位点密度。
例如,利用氧气等离子体(O2 plasma)或紫外光辐射手段可以极大的提升衬底表面羟基(-OH)数量,如图(a)所示。
ALD工艺所涉及的二元反应序列分为四个步骤,如图(b)所示。
首先,前驱体 A 通入反应腔体与衬底表面活性位点发生自限制表面反应,吸附一层单原子层并产生对应的副产物,随后,利用惰性气体 Ar 吹扫整个腔体与管路,排空残留的前驱体 A 与反应副产物。
接下来,前驱体 B 通入反应腔体并与前驱体 A 所提供的活性位点发生自限制表面反应,吸附另一层单原子层并伴随着副产物的产生,最后,Ar 再次作为清洗气体将残留的前驱体 B 与对应副产物排出,重新暴露的活性位点又能够与前驱体 A 发生反应。此时,一个循环结束,一层产物完成生长。重复以上循环 N 次,根据使用需求定制 ALD 工艺参数。因为衬底表面活性位点数量是有限的,所以通过半反应沉积的表面物质也是有限的,对应于每个表面半反应都具有各自的饱和状态。如果两个独立表面半反应中的每一个反应都是自限制的,那么这两个反应可以连续、交替地进行,获得薄膜的逐层沉积过程,并满足原子级可控。
ALD 过程由表面化学反应所控制,由于其表面反应是顺次、交替进行的,所以两种前驱体在气相中不会发生接触,二者的分离抑制了可能发生的类似于 CVD 的气相反应,避免了薄膜表面颗粒产物的出现。虽然前驱体材料具有自限制反应特性,但是由于前驱体气体流量不同,表面活性位点的反应也具有先后顺序。前驱体可能会以范德华力的形式物理吸附在表面反应已经完成了的区域,并随后从该区域解吸附,继续与其他未反应的表面区域反应并产生共形沉积。因为 ALD 技术避免了前驱体通量的随机性,表面反应的自限制性也会产生非统计沉积,这就致使每个表面半反应均被驱使发生并达到近乎饱和。所以 ALD 生长的薄膜非常光滑并且与原始衬底保持共形一致。
由于薄膜生长过程中几乎无表面活性位点残留,因此薄膜倾向于连续且无针孔的状态。这一特性对于优异介电薄膜和水汽阻隔薄膜的制备是非常重要的。
二、ALD薄膜技术的应用
目前,ALD 技术在超薄与超精细薄膜制备中有着巨大的应用前景。Al2O3、SiO2和ZnO等典型薄膜材料已被应用于各种电子行业。
近年来,薄膜沉积和组分调控已广泛应用于微/纳米制造技术,如机械结构、电气隔离和连接等。
国际半导体技术发展路线图(ITRS)将 ALD 技术应用于 MOSFET 结构中的高介电常数栅极氧化物和后端互连中的铜扩散阻挡层的制备。由于半导体工艺的小型化布局,以及由此带来的产品高深宽比结构,使薄膜沉积技术的精确控制与保形涂覆成为了关键技术需求,而 ALD 工艺为该需求提供了有效的解决方案。
除此之外,由于 ALD 技术所生长的薄膜拥有优异的致密性,其能在百纳米厚度以内形成很好的气体分子阻隔屏障,超薄的薄膜形态为柔性产品应用提供重要的技术支持。所以当前 ALD 技术被广泛认为是未来光电子器件有效的保护手段之一,基于 ALD 的薄膜封装技术相比于现有封装手段,展现出了更轻薄的封装重量和更优异的柔韧性。
美国斯坦福大学 S. F. Bent 教授认为 ALD 因其原子尺度薄膜生长精确可控,将会成为解决薄膜封装问题的有效方案。目前,通过 ALD 技术所制备的 Al2O3、ZrO2、SiO2、HfO2 等无机材料均已经开展了很多研究工作并取得了优异的封装效果。
然而,基于 ALD 技术的薄膜封装材料通常以氧化物为主,金属与氧原子在分子结构中存在稳定的二元键,导致氧化物薄膜具有较高的杨氏模量,随着薄膜的密度和厚度的增加,薄膜趋于刚性化。
此外,为满足低温沉积需求,常常采用等离子辅助 ALD 技术(Plasma Enhanced Atomic Layer Deposition, PEALD)来弥补低温反应活性的不足,然而,O2 plasma的引入为薄膜内部带来了较大的残余应力。归因于 ALD 生长的无机材料的固有性质,如低延展性、低断裂韧性和高脆性,使无机封装材料在机械运动过程中的耐久性和可靠性受限,无机薄膜虽具备优异的封装性能,但却无法在严格的机械运动下保持封装稳定性。
与 ALD 技术类似,分子层沉积(Molecular Layer Deposition, MLD)技术能够将单分子层逐层沉积至衬底表面,往往用于有机或有机无机杂化材料的生长。值得注意的是,MLD 技术中往往存在一些有机成分的引入,其所制备的有机或有机无机杂化薄膜机械性能优异。然而,MLD 往往采用有机前驱体作为单分子层的表面生长单元,其包含的长链有机结构导致前驱体材料分子体积较大,在半反应过程中容易在衬底表面形成空间位阻,并遮挡部分活性位点,表面反应饱和程度因此受限,残留的活性位点在薄膜内部引起了较多的缺陷状态,这些缺陷位置就有机会为环境水汽提供渗透路径,极大地影响了薄膜的水汽阻隔性能。
三、单层与叠层封装薄膜制备过程
在 PEALD 和 MLD 工艺过程中,反应室的压力保持在 0.25 Torr,并采用流速为 100 sccm 的高纯度 Ar(99.999%)作为载气和前驱体的清洗气体,PEALD 和 MLD 过程均发生在如下图所示的设备中。

PEALD-Al2O3的生长过程如下:三甲基铝(Trimethylaluminum, TMA)(99.9999%)和 O2 plasma 分别作为 PEALD-Al2O3 的金属前驱体和氧化剂。
在整个工艺过程中,保持 TMA 处于室温,O2 plasma 由 15 sccm O(2 99.999%)在 100 W 的射频功率下产生。衬底温度被设定为 80 °C,PEALD-Al2O3 生长的典型工艺参数为:O2 plasma 脉冲 10 s,吹扫 100 s,TMA 脉冲 0.04 s,吹扫 100 s。
MLD-alucone的生长过程如下: TMA 和乙二醇(EG,99.8%)分别作为 MLD-alucone 的金属前驱体和氧化剂。在整个工艺过程中,保持 TMA 处于室温下,EG 被加热到 80 °C 以提高反应活性。衬底温度被设定为 80 °C,MLD-alucone 生长的典型工艺参数为:TMA 脉冲 0.04 s,吹扫 100 s,EG 脉冲 4 s,吹扫 120 s.
参考文献:
(1)徐旭 利用PEALD/MLD 技术实现柔性有机电致发光器件的有机无机杂化薄膜封装大口径主镜薄膜制备及其特性研究[D].
(2)张嘉翔 硒化铟的分子束外延生长与性能研究[D].
(3)夏玉敏 新型二维材料的分子束外延制备和扫描隧道显微镜研究[D].

来源:半导体全解
关键词: 薄膜制备技术