嘉峪检测网 2025-09-26 22:02
导读:今天的主角是一批还没米粒大的三极管。本来指望它们能在客户那里大放异彩,结果没走出实验室,就在可靠性测试环节“集体阵亡”。
随着集成电路(IC)技术的发展,芯片尺寸不断缩小,厚度持续降低。这在提升单位晶圆产出、降低封装高度的同时,也带来了新的挑战。硅片的易碎特性使其在组装和测试过程中,即便受到中等强度的应力,也可能发生开裂。
今天的主角是一批还没米粒大的三极管。本来指望它们能在客户那里大放异彩,结果没走出实验室,就在可靠性测试环节“集体阵亡”。
故障案例分享
1.故障背景与样品描述
失效样品:塑封分立器件(三极管)
封装尺寸:1.0×0.6×0.5mm;
芯片尺寸:260×260µm;
芯片厚度:4mil (约100µm);
失效现象:样品在可靠性测试后,功能失效,I-V测试确认存在漏电。
2.实验与分析过程
2.1化学开盖与初步观察
为探究失效的内部原因,我们对5个失效样品进行了化学去封装处理。通过光学显微镜观察,发现所有样品的芯片表面均存在裂纹。

2.2裂纹溯源与腐蚀实验
为了定位裂纹的起源,我们进行了两组实验:
第一组 (暴露硅晶圆):将去封装后的样品放入王水中腐蚀,以暴露硅的断裂面。通过SEM检查发现,裂纹从芯片背面(底部)垂直向上延伸至芯片表面。这表明裂纹起源于芯片底部。

第二组 (暴露Die Attach区域):将样品腐蚀暴露芯片粘接(Die Attach)区域。结果在粘接区域表面观察到与裂纹路径一致的白色线条状凸起物。作为对比,良品在同样处理后未发现此类现象。推测这些凸起物是由于高温下芯片开裂,然后芯片粘接层渗透至裂缝中并固化形成的。

2.3 横截面分析
为了验证粘接层渗透的推测,我们对一个失效样品进行了横截面分析。分析结果清晰地显示,裂纹从芯片底部产生,并向上扩展,同时芯片粘接材料确实已渗入裂缝中,这与之前的推测完全吻合。

为了进一步探究芯片裂纹的根本原因,研究人员对另外4个失效样品进行了去封装和蚀刻,以观察裂纹的扩展路径,均为垂直贯穿裂纹。

2.4 裂纹模式统计
我们对92个失效样品进行了去封装和光学检查,根据裂纹形态将其分为三类:A型 (垂直裂纹):占比最高,达到79.3%;B型 (水平裂纹):占比较低;C型 (对角线裂纹):占比较低。
裂纹模式的高度集中(A型为主)表明,失效原因可能并非来自晶圆加工(如研磨、切割)等引入的随机缺陷,而更可能源于一个系统性的、方向一致的外部应力。
3. 裂纹根本原因分析
3.1 裂纹产生机理
芯片开裂与硅中的缺陷或微裂纹密切相关,这些缺陷或微裂纹是裂纹扩展的起始点。晶圆加工步骤,如减薄和切割,可能会在硅芯片中引入缺陷或微裂纹。例如,在减薄过程中,表面缺陷可能被引入;通过晶圆切割,边缘缺陷如微裂纹会进一步产生。常见的裂纹类型包括:
1)水平芯片开裂:通常由芯片边缘的应力集中引起,是较为常见的模式。
2)垂直芯片开裂:通常由芯片弯曲,导致其背面受到拉伸应力而产生。裂纹从背面缺陷处(如研磨划痕)开始,并向芯片表面扩展。这种模式需要较大的应力才能触发。

在半导体晶圆和集成电路制造中,背面研磨是至关重要的工艺之一。背面研磨通常分为粗磨和抛光两个阶段。机械研磨技术常用于减薄过程,但研磨后通常会产生表面缺陷或划痕。随后的晶圆背面抛光有助于减少粗磨过程中产生的残余应力。机械研磨和抛光的不同技术和工艺参数将决定晶圆背面残留缺陷的严重程度。此外,单个芯片背面划痕方向的差异也会影响裂纹方向。

当受到应力载荷时,微裂纹有很高的可能性会扩展并导致芯片断裂。因此,芯片开裂在组装过程或可靠性测试中很常见。例如,在模塑过程中,极高的模塑压力或夹紧力可能导致硅芯片开裂,芯片的引线键合也可能导致芯片断裂。
从芯片裂纹分类表中裂纹模式主要为A型,B型和C型较少。由于晶圆研磨和切割引起的裂纹类型应是均匀的,并且在现代成熟技术中,失效应该是独立的且数量较少,因此判断晶圆加工引起的缺陷可能部分导致了本次失效中的裂纹,但并非主要原因。
热应力排除:热应力(由芯片、引线框架和塑封料之间热膨胀系数不匹配引起)通常导致水平裂纹。本案例中均为垂直裂纹,因此基本可以排除热应力是主因。
3.2 应力来源分析
本案例中的裂纹均为垂直开裂,裂纹起源于芯片底部,并向上方扩展,表明芯片受到了显著的弯曲应力。

从上图可见,裂纹运动方向几乎垂直于施加的拉伸应力方向,并产生相对平坦的断裂表面。宏观上,断裂表面具有刻面纹理。这种断裂需要较大的强度。如下图所示,当芯片底部受到拉伸,且拉伸应力超过芯片背面的拉伸强度时,就会发生开裂。

有限元建模 (FEM):我们使用ANSYS软件建立了芯片的3D有限元模型,模拟芯片在受到弯曲力时的应力分布。模拟结果显示,当芯片向上弯曲时,其底部会产生最大的拉伸应力,而顶部则为压应力。这一结果与观测到的“裂纹从底部发起”的现象完全一致,证实了芯片开裂与弯曲应力之间存在明确关联。
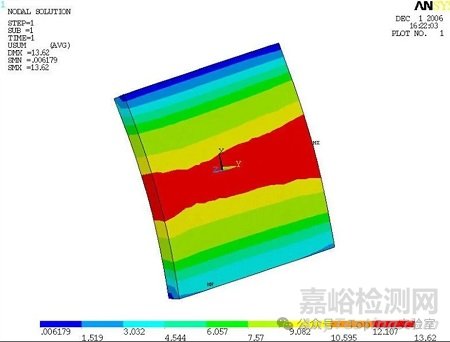
机械应力调查:既然热应力并非主因,那么施加在芯片上的巨大弯曲力从何而来?调查最终指向了组装后的测试环节。通过专项检查发现,失效批次所使用的测试设备(Test Handler)的分离器(Separator)存在运动异常。正常情况下,分离器应平稳移动,但异常设备的分离器在X轴方向的移动不受控制,当分离器从线性轨道盖移出时,被测单元撞击拾取头。进一步的根因追溯发现,设备导销(Guide Pin)的磨损是导致分离器运动不稳定的根本原因。

4.结论
本次芯片开裂失效的根本原因是:测试设备导销磨损,导致其分离器运动异常,在芯片拾取过程中对封装体施加了不均衡的机械冲击载荷。该机械冲击导致芯片发生向上弯曲,使其背面处于强烈的拉伸应力状态下。当该应力超过硅材料的断裂强度时,裂纹便从芯片背面的微缺陷处萌生,并垂直向上扩展,最终贯穿整个芯片,导致器件失效。

来源:Top Gun 实验室