嘉峪检测网 2025-02-15 20:03
导读:DPA是一种通过对芯片进行破坏性拆解和分析,评估其设计、材料、工艺等方面潜在缺陷的可靠性测试方法。
《红色巨人》,一家神秘的公司,其生产的产品的服役时间≥20年。为了确保产品质量,红色巨人将破坏性物理分析(DPA)贯穿于产品研发、生产和质量控制的每一个环节。DPA是一种通过对芯片进行破坏性拆解和分析,评估其设计、材料、工艺等方面潜在缺陷的可靠性测试方法。
红色巨人的DPA实践:
1)研发阶段: 在产品设计初期,我们就引入DPA分析,对关键元器件和材料进行严格筛选,优化设计方案,从源头提升产品可靠性。
2)生产阶段: 我们对每一批次来料进行抽样DPA分析,监控来料生产工艺稳定性,及时发现并解决潜在问题,确保产品的一致性和可靠性。
红色巨人的DPA流程、测试要求和典型判据:
|
|
|
|
|
|
|
|
|
1、丝印符合规格书,清晰,无缺损或缺项,内容具有追溯性。 2、芯片封装、引脚符合规格书尺寸要求,无污染,受损或变形。塑封层无空洞或裂纹。 |
|
|
|
|
1、存在包括键合丝区域的分层。 2、塑封和芯片之间任何可测量的分层或空洞。 3、跨越键合丝的模塑化合物的任何空洞。 Flip-chip声扫不合格判据 1、bump区域存在任何可测量的分层。 2、底充胶与任何界面分层超过总面积的10%。 |
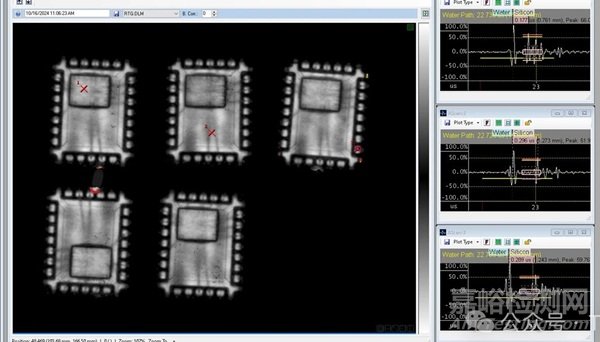 |
|||
|
|
|
所有样品检查正面die粘接料覆盖率和die边缘是否有carck,有异常则保留图片,无异常就按照下面要求拍2个样品。 2pcs存图,俯视图要能看清晶圆粘接和键合丝,侧视图需要能看清芯片粘接材料爬高 |
1、晶圆粘接正常,单个空洞面积不超过总面积的10%,总空洞面积不超过总面积的30%。 2、引线无短路、断路或变形,无交叉,引线之间或引线与die之间无搭接短路现象。 3、芯片粘结材料(焊锡、焊膏、银浆等)不能延伸至die表面。 |
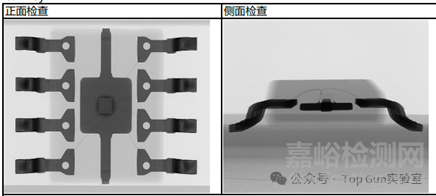 |
|||
|
|
|
|
|
|
|
|
|
|
|
|
|
a、芯片全貌+芯片尺寸测量 b、键合丝直径,一焊点球径测量 c、Die logo拍照 d、芯片局部放大图,量测切割道到seal ring的尺寸 |
1、需要有die ID,并可明确器件型号,无ID时需跟厂家确认。 2、其他按内部目检要求判定 |
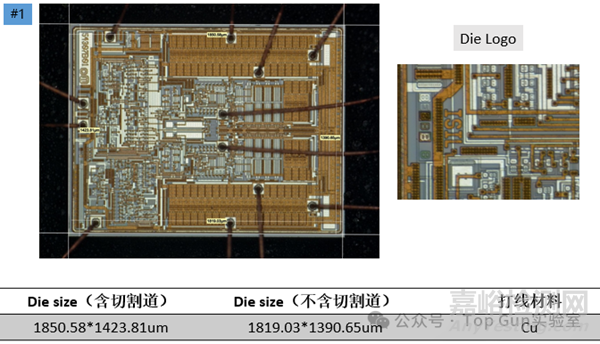 |
|||
|
a、切片全貌 b、1焊点切片局部放大 |
1焊点IMC无明显异常,吃铝深度为铝垫厚度的1/3~1/2 |
||
|
|
|
a、SEM全貌 b、芯片+1焊点全貌 c、1焊点放大局部形貌(≥3个) d、2焊点放大局部形貌(≥3个) |
无明显脱线痕迹和钝化层与金属层缺陷 |
|
|
|||
|
a、切片全貌SEM图 b、seal ring位置局部SEM图 c、内部线路SEM图+能谱mapping d、1焊点切片图+球径球高测量+键合丝能谱mapping |
1焊点IMC无明显异常,吃铝深度为铝垫厚度的1/3~1/2 |
||
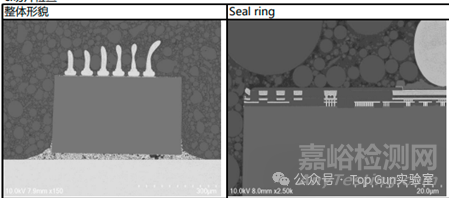   |
|||
|
|
|
|
铝pad下层SiO2层不存在裂纹。 |
|
去铝垫前 |
去铝垫后弹坑检查 |
||
破坏性物理分析(DPA)作为一种重要的可靠性评估手段,其具体流程和要求会根据产品的质量等级、应用场景、行业标准等因素而有所不同。例如,航天航空、军工等领域对产品可靠性要求极高,其DPA流程会更加严格,分析项目也更加全面;而消费电子等领域,则会根据成本控制和实际需求,制定相应的DPA规范。
红色巨人DPA检验规范说明:
本DPA流程是红色巨人根据自身产品的质量要求制定的DPA检验规范,旨在通过科学严谨的DPA分析,确保产品的高可靠性和稳定性。本流程仅供参考,其他企业可根据自身产品特点和质量要求,参考相关标准制定适合自己的DPA检验规范。
可供参考的标准:
行业标准:
SJ/T 10466 半导体器件破坏性物理分析方法和程序
SJ/T 10694 混合集成电路破坏性物理分析方法和程序
国际标准:
MIL-STD-883 微电子器件试验方法和程序
MIL-STD-1580 航天和导弹系统用电子元器件破坏性物理分析(DPA)
JEDEC JESD22 系列标准

来源:Top Gun实验室
关键词: 芯片