嘉峪检测网 2025-03-17 08:39
导读:本文介绍了IC设计中的四种常见失效机理:EM, TDDB, NBTI/PBTI, HCI。
四种常见的器件失效机理
EM:Electron Migration,电迁移
TDDB:Time Dependent Dielectric Breakdown,经时击穿
NBTI:Negative-Bias Temperature Instability,负偏置温度不稳定性
PBTI:Positive Bias Temperature Instability,正偏置温度不稳定性
HCI:Hot Carrier Injection,热载流子注入
EM:
EM:指在高电流密度下电子的流动导致金属原子移动的现象,也称之为“金属迁移”。在电流密度很高的导体上,电子的速度较快,可能使一些金属原子脱离金属表面到处流窜,结果将会导致原本光滑的金属导线的表面变得凹凸不平,进而造成永久性损伤。
这种损伤是个逐渐积累的过程,当这种“凹凸不平”多到一定程度的时候,将会导致IC互连线路出现空洞、断裂或短路的现象,而最终使得IC报废。温度越高,金属离子越活泼,电子越容易推动这种迁移,其损害线路花费的时间就越少,即IC的寿命也就越短,这也就是高温会缩短IC寿命的本质原因。
影响因素:温度,电流密度,几何尺寸和形状,金属材料
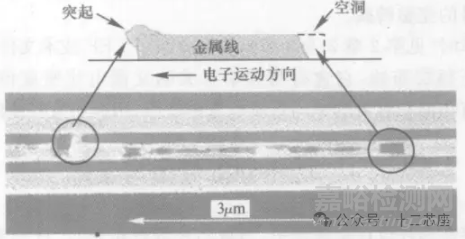
电迁移现象示意图
TDDB:
经时击穿(TDDB):指栅氧化层等薄介质材料在长期电场作用下逐渐退化,最终导致绝缘失效的现象。其核心机理是介质内部缺陷(如针孔、杂质)在高电场下引发电荷注入和陷阱积累,最终形成导电通路。失效时间 tBD 与电场强度 E 和温度 T 密切相关。
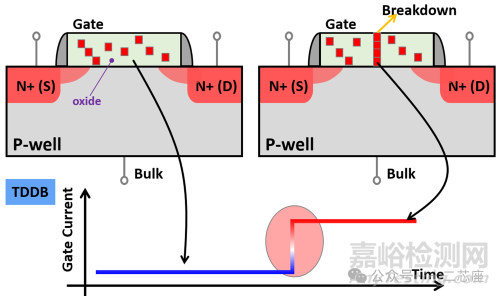
栅氧化层寿命预测:通过加速测试(施加高于工作电场的电压),测量不同条件下的 tBD,外推实际工作电场下的器件寿命。例如,用 E 模型(热化学击穿模型)或 1/E 模型(空穴诱导击穿模型)进行拟合。
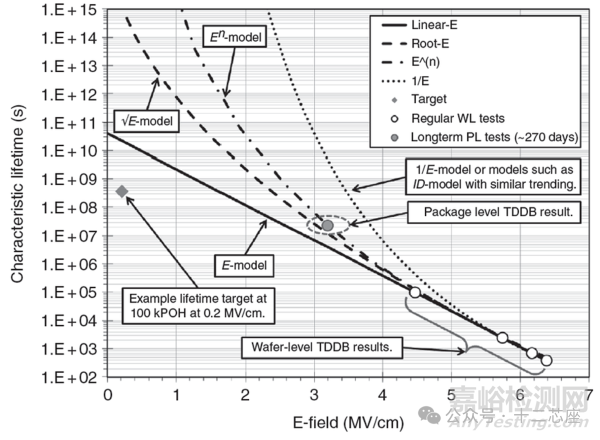
下图对比了在SiO₂和HfO₂两种材料中,由双电子注入引发的导致氧化层退化和击穿的微观机制。过程始于氧化层中存在的缺陷前体(Defect precursor, P),在SiO₂中为宽O-Si-O键,在HfO₂中为氧空位(Vo)。当缺陷捕获两个电子后,会生成一个间隙氧离子(O²⁻)和一个氧空位(Vo)。新生成的 Vo 在捕获两个电子后,又会形成新的 Defect precursor,这一循环持续进行,直至氧化层发生击穿。

在SiO₂中,宽O-Si-O键作为 precursor(图a),而在HfO₂中,Vo 是最常见的 Defect precursor 位点(图f)。然而,在这两种情况下,当一个P位点捕获2e⁻(如图b所示为SiO₂,图g所示为HfO₂)时,相邻的键被削弱,再加上电场和温度的影响,导致 Frenkel 对的形成,即中性的Vo(这些是主要协助介电层中电荷传输的缺陷)和氧离子(O²⁻),见图c(SiO₂)和图h(HfO₂)。新生成的 Vo 可能会增加漏电流,并最终导致介电击穿。此外,如图d-e所示,当生成的 Vo 捕获 2e⁻(即图中的Vo²⁻)时,在其附近会形成一个新的 Defect precursor 位点(即对于SiO₂来说是宽O-Si-O键),从而促进一个自维持过程。在HfO₂中,Vo 既作为增加漏电流(最终导致介电击穿, dielectric breakdown)的缺陷,又作为 Defect precursor 位点,协助新 Vo 缺陷的形成。
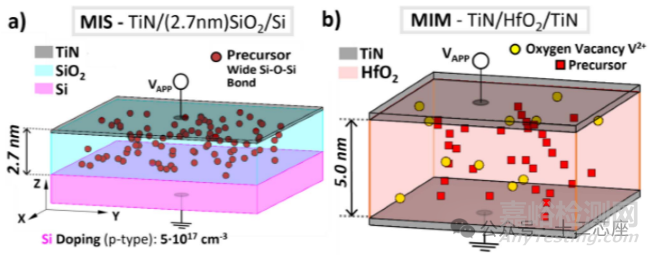
工艺缺陷检测:TDDB 测试可暴露二氧化硅层中的针孔、杂质等微观缺陷。初始微缺陷可能被薄氧化层暂时覆盖,但长期电场作用会通过 TDDB 效应引发击穿失效。
影响因素:电场强度(高电场显著加速TDDB过程);温度(温度升高会缩短失效时间);介质质量(SiO2, HfO2 等栅介质厚度均匀性、界面态密度、杂质含量直接影响TDDB寿命)。
NBTI:
NBTI:指在 IC 芯片工作中,PMOS 的栅极氧化层在受到负偏置和高温作用时,其性能发生退化的一种现象。具体表现为 MOS 管的阈值电压 VT 发生正向漂移,导致导通电流 Ion 下降、延迟增加,最终影响芯片的 performance and reliability.
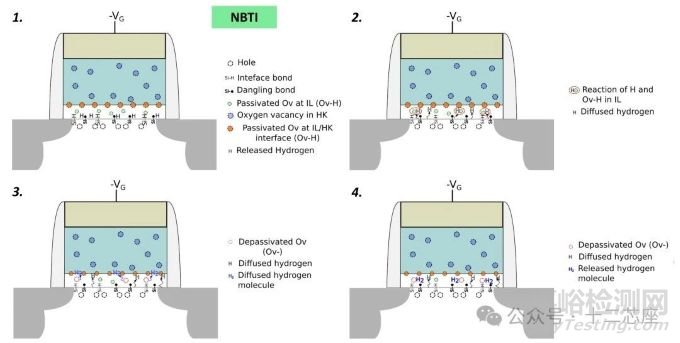
MOSFET导电通道中的空穴反型层破坏了位于Si/IL界面的Si-H键;释放出的氢原子从界面过渡层(SiOx)和IL内扩散;当到达Si/IL界面时,这些氢原子与更多的氢原子反应,破坏Vo-H(Oxygen vacancies passivated with hydrogen,被氢钝化的氧空位)键。键破坏后会产生悬挂键,并且在界面层内形成H₂分子,因此在较长的应力作用时间下,NBTI将由从Si/IL到IL/HK界面的H₂分子扩散所主导。
捕获空穴 :在负偏置条件下,栅极电压吸引空穴向栅极氧化层界面移动。这些空穴会被氧化层中的陷阱捕获,形成固定的正电荷。捕获的空穴会改变氧化层的电场分布,导致阈值电压发生漂移。

Si-H 键的断裂与重构:在负偏置电场的作用下,由于 Si-H 键的键能相对较小,氢原子容易从 Si-H 键中解离出来,形成氢空位和悬挂键。悬挂键会增加界面态密度,捕获更多的空穴,加剧阈值电压的漂移。同时,解离出来的氢原子可能在氧化层中迁移,重新与其它硅原子结合,形成新的 Si-H 键,这一过程可称为重构。重构虽然可以在一定程度上恢复晶体管的性能,但无法完全抵消 Si-H 键断裂带来的负面影响。
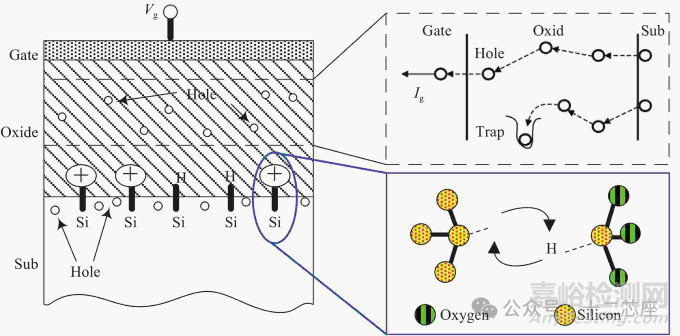
详细地说,当晶体管开始工作时,PMOS 晶体管的栅源电压处于负偏置状态(Vgs=-Vdd)时,当经历高温和一定时间的负偏置状态后,在 Si-SiO2 界面处作用力较弱的 Si-H 键会发生断裂,使沟道内留下界面陷阱和氢原子。而氢原子的不稳定性会使其更容易结合成氢气,并从器件的栅极溢出。伴随负偏置状态持续时间不断增加,界面陷阱的密度呈直线上升,导致PMOS晶体管的阈值电压 VT 也不断升高;当PMOS晶体管的栅源电压处于正偏置状态(Vgs=0)时,这个阶段可以成为重构阶段。此时,之前由氢原子结合成的部分氢气在获得能量的情况下重新断开,并在反向电场的作用下与界面陷阱(Si+)重新结合形成新的 Si-H 键,这样会使沟道内的界面陷阱的密度下降,从而使得晶体管的阈值电压得到恢复。
PBTI:
随着工艺节点的推进,PBTI 也不容忽视。PBTI的全称是 Positive Bias Temperature Instability,它与 NBTI(Negative Bias Temperature Instability)类似,但作用于 NMOS 而非 PMOS。PBTI是指在芯片工作过程中,NMOS 晶体管的栅极氧化层在受到正偏置和高温作用时,其性能发生退化的一种现象。具体表现为晶体管的阈值电压发生负向漂移,导致驱动电流下降、延迟增加。

与NBTI一样,PBTI模型由三个相互独立的组成部分:
(1)界面陷阱在IL/HK界面的产生;
(2)电子被陷阱捕获进入HK介质层中的预先存在的缺陷;
(3)在应力作用下,HK介质层内陷阱的产生。
图中显示了在HKMG技术中,PBTI由界面陷阱生成所主导。在这种情况下,界面陷阱的生成在界面和高-κ介质层之间,以及在高-κ介质层内被钝化的氧空位的激活,都是由于电子在沟道处于反型时隧穿进入界面介质并向IL/HK界面移动,导致Vo-H键断裂。在IL/HK界面释放的氢原子扩散、反应,并在高-κ介质和金属栅电极(HK/MG)界面处破坏钝化的缺陷。从HK/MG界面扩散的H₂分子是PBTI的主导因素。
对于NBTI效应来说,加反向电压能进入恢复模式;对于HCI效应来说,停止使用能进入恢复模式。但是虽然可以一定程度上恢复部分性能,但长时间而言,芯片是会逐渐老化的。
HCI:
在短沟道晶体管中,由于Si–SiO2界面附近的高电场,电子或空穴可以从电场中获得足够的能量,以跨越界面势垒并进入氧化层。这种效应被称为热载流子注入。相较于空穴,电子从Si注入到SiO2的可能性更大,因为电子的有效质量低于空穴,并且空穴的势垒高度高于电子的势垒高度。热载流子:在高电场中,载流子被加速并获得高能量,这些高能载流子称为热载流子。注入机制:热载流子可能穿过栅氧化层,导致氧化层损伤或界面态增加。
在MOSFET中,HCI的产生主要与以下四种机制相关:
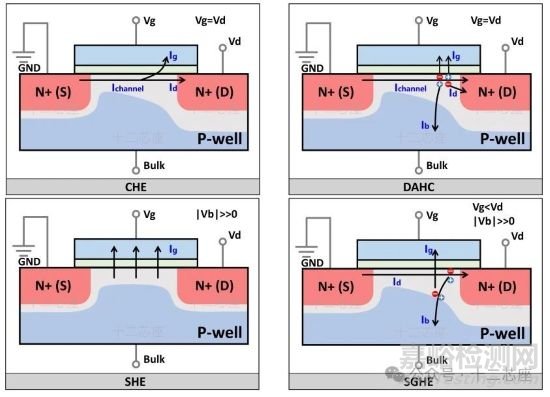
四大失效机理对比图

Reference:
1.Advanced Concepts for TDDB Reliability in Conjunction with 3D Stress.
2.From Accelerated to Operating Conditions: HowTrapped Charge Impacts on TDDB inSiO2 and HfO2 Stacks.
3.Model of NBTI combined with mobility degradation.
4.On the Prediction of the Threshold Voltage Degradation in CMOS Technology Due to Bias-Temperature Instability.

来源:十二芯座