嘉峪检测网 2025-07-20 04:53
导读:Flip-Chip封装铜迁移失效。
一、背景
Flip-Chip封装在高端芯片中越来越普及,但按照JEDEC标准的bHAST条件(130℃/85%RH 96 h)加速试验却频频报“漏电/短路”失效,而传统的THB条件(85 ℃/85%RH 1000 h)却一切正常。
LSI实验室用6层板--2-2-2 build-up substrate当做试验对象,通过试验设计设计了一组对照试验,根据长时间的系统实验,找到了问题根因——铜迁移。
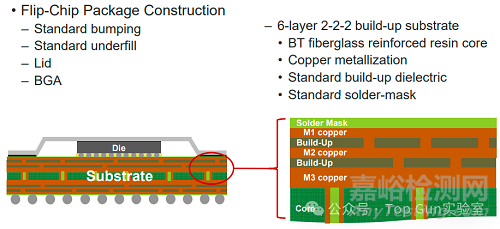
二、JEDEC JESD47和湿度相关的实验一览
湿度分带电(Biased)和不带电(Unbiased)两种,这两种分别考核不同的失效模型和机理。
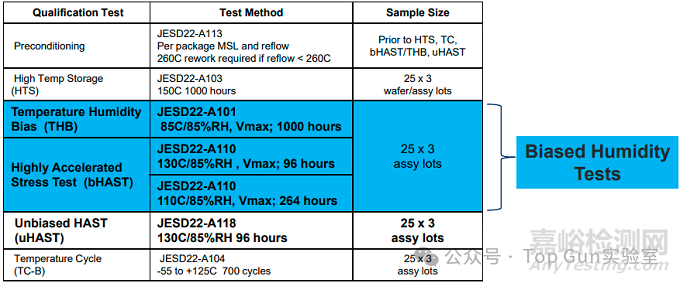

失效模型和机理简介
1、Biased(带电)--“电化学迁移”模型,关键词:电场 + 离子 + 金属迁移
机理
水汽在树脂或界面形成连续水膜,成为电解质;
阳极金属(Cu、Ag、Sn)被电解:Cu → Cu²⁺ + 2e⁻;
金属离子在电场作用下向阴极迁移;
到达阴极后被还原,形成树枝状金属须(Dendrite);
须状物桥接两极,造成瞬时短路或漏电流增加。
典型失效形态
铜须沿Build-Up树脂内部生长(Flip-Chip 案例);
银迁移沿 PCB 表面绿油边缘爬行;
焊球间桥接,导致BGA短路。
驱动因子排序
电场强度 > 湿度 > 温度 > 金属活性。
考核目的
模拟产品在工作电压下长期受潮,评估电路功能性失效风险。
2、Unbiased(不带电)--“化学腐蚀 / 氧化”模型,关键词:水汽 + 杂质离子 + 无电场
机理
水汽吸附在金属表面,溶解空气中的 CO₂、Cl⁻、S²⁻ 等形成弱酸;
金属发生均匀腐蚀或局部点蚀,生成氧化物或盐膜;
无电场驱动,离子不会定向迁移,因此不会长出金属须;
腐蚀产物导致接触电阻升高、键合强度下降,但不会瞬间短路。
典型失效形态
铝键合盘发黑(生成 Al₂O₃ 或 AlCl₃);
铜焊盘绿锈(Cu₂(OH)₃Cl);
锡球表面氧化,后续装配虚焊。
驱动因子排序
湿度 > 杂质离子浓度 > 温度。
考核目的
模拟运输、仓储或断电停机时的受潮风险,评估长期可焊性与机械完整性。
一句话总结
Biased 怕“铜树”——短路的瞬间杀手;
Unbiased 怕“生锈”——性能的慢性毒药。
三、LSI实验室验证设置的实验条件 vs 结果速查表

结论:温度 ≥125 ℃ + 高湿度 + 电场 是铜迁移三要素。
失效形貌:实验失效的样品可见铜离子迁移形貌


四、物理失效模型(通俗易懂版)
吸湿后 Tg 降低:build-up 树脂干态 Tg≈150 ℃;吸湿后降到 125 ℃ 以下。
树脂软化:温度 > Tg → 自由体积增大,铜离子“游”得动。
电场驱动:Cu → Cu⁺ + e⁻,离子沿电场沉积到阴极,形成铜须。
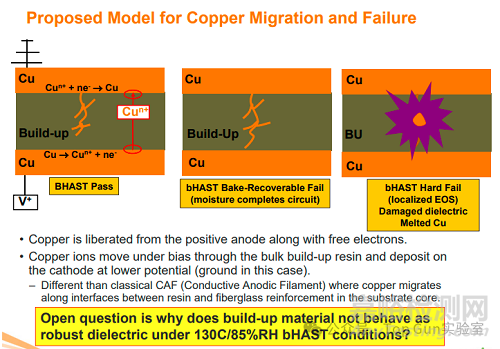


五、对可靠性工程师的 3 点启示
慎用 ≥125 ℃ 的 bHAST
JEDEC 已提示可能产生“人造失效”,本实验证实。
如需加速,优先提高湿度而非温度
110–120 ℃/85 %RH 区间 528 h 仍无失效,时间换安全。
设计端考虑
• 增加铜-铜间距
• 选用低吸湿 build-up 材料或低离子含量树脂

来源:Top Gun 实验室
关键词: Flip-Chip封装铜 迁移失效