嘉峪检测网 2025-06-17 08:26
导读:本文介绍了多次回流焊接金属间化合物(IMC)厚度测试结果分析。
一、IMC简介
1、IMC定义
IMC(Intermetallic compound)即焊接界面合金间化合物,是焊料合金和所焊接的金属之间在高温中快速形成一薄层锡合金化合物,之后还会逐渐生长增厚。

2、IMC产生机理
在SMT焊接过程中,焊接基材表面(铜、镍、金、银等)和熔融锡合金焊料之间,原子相互结合、迁移、扩散,在冷却固化后立即出现一层薄薄的金属化合物。
3、常见IMC类型
不同合金焊接后对应的IMC合金成分如下图所示。

不同IMC对应的特性如下表。

4、IMC力学特性及影响
脆性问题:IMC本身具有脆性,若其厚度不合理,会对焊点的机械强度和寿命产生不利影响,尤其会严重危害焊点的抗疲劳强度。
强度与厚度的关系:当IMC厚度合适时,焊点的焊接强度高,同时电气连接也较为可靠,能保证产品的正常性能和稳定性;若IMC厚度不足,容易使焊点出现虚焊现象,还会对产品的性能造成不良影响,导致产品在使用过程中可能出现各种故障;当IMC厚度过大时,焊点会变得脆性增加,其机械强度随之降低。这将影响产品的长期可靠性,使产品在长期使用中更容易出现焊点断裂等问题,缩短产品的使用寿命。
5、IMC的生长
IMC生长速度与温度成正比,常温下IMC生长较慢。
OSP板在常温下IMC生长缓慢,高温下IMC生长则比较快速。
在高温下镀金板IMC生长速度比OSP板IMC生长速度慢很多。
6、推荐IMC厚度:1~4μm(也有资料推荐0.5~4μm)。
二、多次回流焊接后IMC厚度
1、测试样品
取4PCS样品,焊盘表面处理工艺是OSP,贴装BGA芯片分别进行1-4次回流焊接,取BGA芯片进行切片试验,测量IMC厚度。如下图所示。
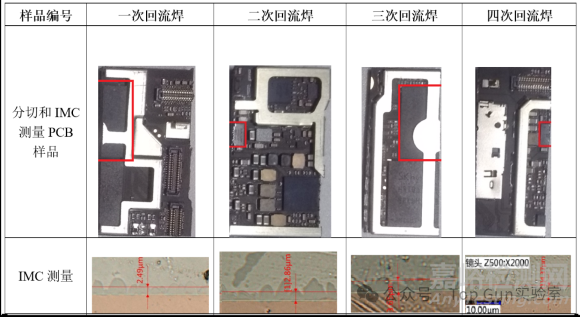
2、测试结果
样品回流1-4次后IMC厚度数据及平均值,如下表所示。

3、数据分析
回流焊接次数影响IMC生长趋势图如下:
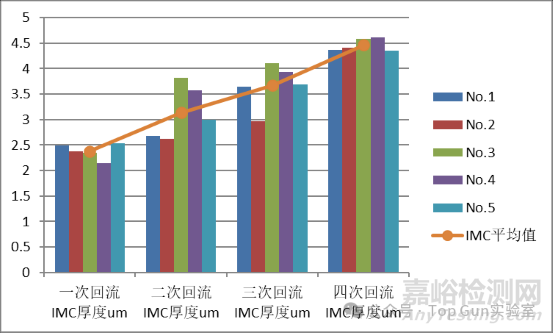

结论:IMC层厚度随回流焊次数增加而增加,第四次回流焊后IMC厚度超过了4μm。
4、继续试验第5次焊接后IMC厚度
切片后的测量IMC数据5.1μm,如下图所示:
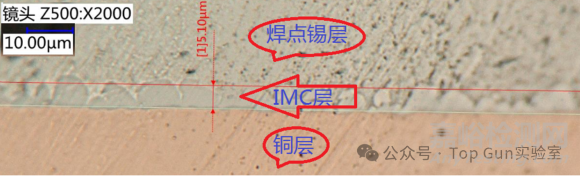
5、IMC形态变化
随IMC的生长,界面的合金毛刺状结构趋向平滑,导致结构强度变弱。切片结果如下图所示:


三、行业数据分析
从行业中购买4台竞品机器,进行切片试验,测量IMC数据如下表:
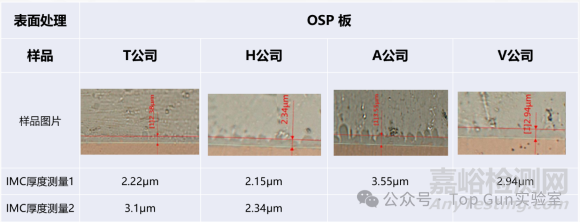
从上表可以看出,各公司产品IMC厚度接近,都小于4μm,其中A公司的产品采用了三明治焊接工艺,三次回流焊接导致IMC厚度测量数据偏大。
四、ENIG 回流焊IMC厚度
取1pcs焊盘表面化学镍金处理(ENIG)的PCB,贴装芯片后分别回流焊接一次和五次,测量IMC厚度如下图:
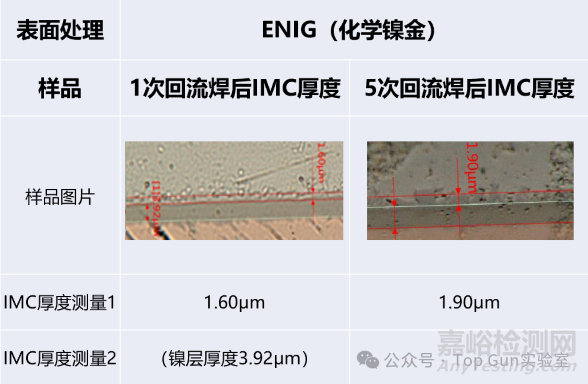
结论:沉镍金板IMC层厚度比OSP板厚度薄,相同条件下IMC生长速度比OSP慢。
五、总结
IMC厚度随回流焊次数增加而增加。4次回流焊后的IMC厚度大于4μm,超出行业要求上限。推荐产品生产焊接次数控制在3次以内。
随着IMC的生长,界面的合金毛刺状结构趋向平滑,结构强度变弱。
IMC厚度与焊接金属面的表面处理有关。镀金线路板比OSP表面处理的线路板IMC合金层薄,在相同条件下镀金线路板IMC的生长速度缓慢。

来源:PCBA设计与制造
关键词: 焊接金属