嘉峪检测网 2025-06-20 08:48
导读:本文介绍了半导体引线框架(Lead Frame)的设计与制造。
在现代半导体技术飞速发展的背景下,引线框架(Lead Frame)作为一种关键的封装结构元件,正日益展现其不可替代的重要性。它是半导体器件的“骨架” ,不仅为硅芯片提供物理支撑,更在实现电信号传输、器件封装稳定性与热量管理等方面扮演着核心角色。可以说,引线框架构建起芯片内部功能与外部电路之间的桥梁,是保障微电子系统高效运行的基础。
这些精密的金属结构通常采用铜、铁镍合金等材料制造,经过冲压、蚀刻、电镀等工艺处理后,能够同时满足高导电性、良好热传导性、机械强度和焊接可靠性的多重需求。它不仅关乎封装质量的稳定性,更直接影响到整机电子产品的性能、寿命与可靠性。

随着电子设备向小型化、高速化和高集成化不断演进,引线框架也面临着更高的技术挑战与创新要求。从传统的DIP封装到现代的QFN、DFN等先进封装形式,引线框架的设计与制造技术已发生了深刻变革。
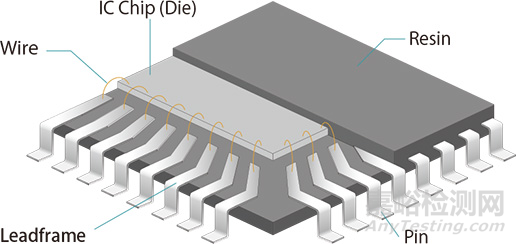
延续这一话题,接下来我们将深入探讨为何这些组件如此重要。继续关注,我们将带您了解支撑电子世界稳定运行的引线框架的材料选择、工艺技术及结构类型,并剖析其在新一代封装技术中的演进路径与应用前景。
1. 什么是引线框架(lead frame)
引线框架是一种用于半导体器件封装的关键金属结构件,通常由铜、铜合金、铁镍合金等高导电金属材料制成,其主要功能是作为芯片与外部电路之间的电气通路与机械支撑结构。在整个芯片封装过程中,引线框架起到固定芯片、引出电信号、导出热量、支撑封装体等多重作用。
引线框架是半导体封装中不可或缺的组成部分,旨在支撑硅芯片并将其连接到更大的电子系统。这些框架通常由具有优良导电性和热传导性的金属材料制成,如铜、铜合金或铁镍合金等,能够为芯片提供坚固可靠的支撑结构,并通过其延伸出的引脚与外部电路建立关键的电气连接。它不仅连接芯片内部的微小电极,还通过焊线或键合的方式,实现电信号从芯片到系统级电路板的高效传输。
在现代电子产品中,电信号的完整性和稳定性直接决定了系统的性能表现。引线框架在这一过程中起着“高速公路” 的作用,它不仅要确保每一条信号路径的电阻、电感等参数满足设计需求,还要具备足够的抗干扰能力,以适应高速和高频信号的要求。

此外,引线框架还承担着至关重要的散热功能。随着芯片集成度提升、功耗增加,如何将芯片运行过程中产生的热量及时有效地传导出去,成为影响电子设备可靠性的重要因素。引线框架通常会设计热焊盘或加强区域,协助将热量传导至封装外部,进而通过系统散热机制释放至空气中,有效避免芯片因过热导致性能衰退或失效。
通过确保芯片在物理上的稳定性和电气上的连通性,引线框架成为众多电子产品正常运行的关键要素。从手机、计算机到汽车电子和工业控制系统,其在封装结构中所承担的功能,直接关系到整个电子系统的性能、寿命和可靠性,是构建现代电子世界的“隐形基石”。
引线框架广泛应用于各类分立器件和集成电路(IC)封装中,如DIP、SOP、QFP、QFN、BGA等。其基本原理是:将晶圆切割得到的硅芯片粘贴在引线框架的安装区,再通过金线、铝线或铜线与引线框架的内引脚进行键合(wire bonding),最后通过塑封材料(如环氧树脂)将整个结构密封,形成完整的半导体器件。

引线框架通常批量生产,呈带状排列以适应自动化封装设备,如固晶机、焊线机、塑封机等。但它并没有统一的标准尺寸,而是依据芯片尺寸、封装形式、热性能、电气性能等需求定制。
1.1 引线框架的重要性
引线框架在半导体行业中扮演着举足轻重的角色,原因在于它是微芯片与外部世界之间不可或缺的“纽带”。现代电子设备几乎无处不在,从智能手机、电脑到汽车电子和工业控制系统,几乎所有设备的核心都依赖于微小的硅芯片。没有引线框架,这些微芯片无法实现稳定可靠的电气连接,更无法有效整合进复杂的电子系统中。
引线框架不仅确保了芯片与外部电路之间的电气接触准确无误,还保证了信号传输的畅通无阻,从而支撑起整个系统的正常运行。与此同时,随着芯片性能和功耗的不断提升,散热成为影响芯片稳定性和寿命的关键因素。引线框架通过高效的热传导能力,帮助芯片将运行时产生的热量及时释放,避免过热带来的潜在损害。
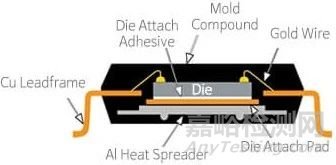
因此,尽管引线框架往往被视作半导体封装中的“幕后英雄”,其重要性却不可低估。它是确保电子产品正常工作和持久耐用的关键基础,为现代电子产业的高速发展提供了坚实保障。
1.2 引线框架常用材料
引线框架的性能在很大程度上取决于所选用的材料。理想的材料不仅需要具备优良的导电性,还要兼顾机械强度、耐腐蚀性及良好的热传导能力。
目前,铜及铜合金是引线框架最常用的材料。铜本身具有极佳的电导率,有助于信号的高效传输,同时热传导性能优异,利于芯片散热。为了进一步提升性能,制造过程中通常会在铜基材表面进行镀镍、镀银或镀金处理,这些金属覆盖层不仅提升了抗腐蚀能力,还改善了焊接性能和整体可靠性。
在某些特殊高性能应用中,为满足极端环境或延长使用寿命的需求,也会选用不锈钢或纯金等贵金属材料。虽然成本较高,但在航空航天、军事或高端消费电子领域,这些材料能提供更稳定的性能保障。综上,铜基合金因其性能与成本的平衡优势,仍然占据引线框架材料市场的主导地位。
1.3 引线框架的主要功能
引线框架作为半导体封装的核心结构,其功能多样且密不可分,共同保障半导体器件的稳定与高效运行:
电气连接:引线框架的首要职责是建立芯片与外部电路间的电气联系。通过引脚和焊线的精密设计,确保信号能够高效、准确地从芯片传输至更大系统,从而保证电子设备的正常工作。
机械支撑:芯片本身极为脆弱,易受机械冲击和应力影响。引线框架为芯片提供坚固的物理支撑,固定芯片位置,防止其在封装及后续使用过程中发生位移或损坏。
热量散发:运行中的芯片会产生大量热能,若散热不良,容易导致性能下降甚至失效。引线框架通过良好的热传导路径,将芯片热量有效导出,帮助维持器件在安全温度范围内运行。
封装辅助:引线框架不仅支撑芯片,还协助封装材料(如环氧树脂)均匀覆盖芯片,形成密封保护层,隔绝外界湿气、尘埃及机械应力,提升器件的环境适应性和使用寿命。
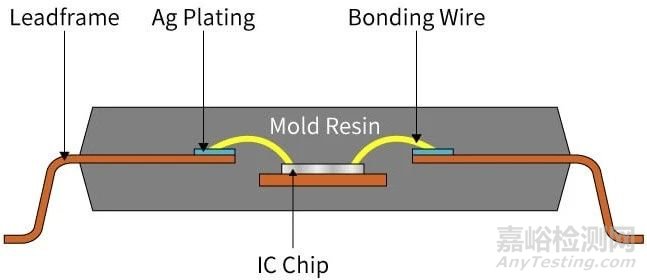
总而言之,正是依赖这些功能,引线框架才能成为现代电子元件不可或缺的基础保障。缺少了它们,电子元件将难以实现高效、稳定和持久的性能表现。
1.4 市场现状
在全球半导体封装产业链中,引线框架(Lead Frame)作为关键的基础材料之一,其制造能力和技术水平对封装效率、产品性能与良率有着直接影响。当前,随着高性能计算、汽车电子和先进封装需求的增长,主要引线框架厂商正加快全球布局,提升产能,深化本地化服务,并通过并购整合和战略合作强化市场地位。
各国主要引线框架制造商正通过扩张产能、提升技术能力、推动绿色制造、加强本地化布局等手段,在全球市场中巩固和提升其竞争力。
|
国家 |
核心方向 |
特点与趋势 |
|
美国 |
用于汽车电子的引线框架材料研发 |
高可靠性、热管理好、面向电动/智能汽车市场 |
|
德国 |
开发环保型引线框架合金 |
符合绿色制造政策,注重材料环保性和回收性 |
|
中国 |
扩大引线框架产能 |
成本低、产能大、正向高端封装进军 |
|
印度 |
研发面向高能效设备的引线框架设计 |
设计为主,制造较弱,政策推动中 |
|
巴西 |
在通信设备中使用引线框架 |
应用驱动型市场,进口依赖强,有本地替代潜力 |
以下列出了当前全球具有代表性的引线框架制造商,涵盖日本、韩国、中国大陆与台湾、东南亚、欧洲等关键地区。这些公司凭借在冲压、电镀、封装兼容性等方面的长期积累,服务于IDM厂、封测代工企业和下游终端客户,在全球市场中占据重要份额。
|
公司名称(中/英) |
总部所在地 |
简要介绍 |
|
三井高科技株式会社(Mitsui High-tec, Inc.) |
日本 |
全球领先的引线框架制造商之一,提供高精密冲压模具和半导体封装材料。 |
|
新光电气工业株式会社(Shinko Electric Industries) |
日本 |
半导体封装领域的重要企业,提供引线框架、基板等,服务全球主要IDM厂商。 |
|
长华科技股份有限公司(Chang Wah Technology Co., Ltd.) |
中国台湾 |
主要从事引线框架、电镀工艺和精密模具的制造,产品广泛应用于IC封装行业。 |
|
Haesung DS(海成DS) |
韩国 |
韩国领先的半导体封装材料公司,专注于引线框架和封装基板的研发和制造。 |
|
ASM太平洋科技有限公司(ASM Pacific Technology, ASMPT) |
新加坡(总部) |
全球著名的半导体设备和材料供应商,引线框架是其封装材料业务的重要组成部分。 |
|
宁波华隆电子股份有限公司(Ningbo Hualong Electronics) |
中国宁波 |
国内知名的引线框架生产企业,产品涵盖多种封装类型,客户包括中芯国际、长电科技等。 |
|
无锡华晶引线框有限公司(Wuxi Huajing Leadframe Co., Ltd.) |
中国无锡 |
专注于高密度、高性能IC封装引线框架的制造,拥有丰富的封装应用经验。 |
|
QPL有限公司(QPL Limited) |
中国香港 |
提供标准和定制型引线框架,服务于亚洲多个半导体封装代工厂。 |
|
晟碟工业股份有限公司(SDI Group, Inc.) |
中国台湾 |
台湾主要的引线框架制造商,产品广泛用于消费电子与汽车电子等多个领域。 |
|
Dynacraft Industries Sdn Bhd |
马来西亚 |
国际知名引线框架供应商,隶属于Cree集团,专注于高密度电路载体的制造。 |
|
榎本工业株式会社(Enomoto Co., Ltd.) |
日本 |
老牌精密冲压与封装材料制造商,长期为IDM厂商提供高可靠性引线框架产品。 |
|
POSSEHL Electronics |
德国 |
德国知名电子组件制造商,旗下封装材料产品线包括高性能引线框架。 |
|
吉霖科技股份有限公司(JIH LIN TECHNOLOGY) |
中国台湾 |
提供各类IC封装金属结构件,包括引线框架、支架、散热片等。 |
|
大日本印刷株式会社(DNP, Dai Nippon Printing) |
日本 |
虽以印刷起家,但在半导体封装材料领域拥有重要地位,生产高端引线框架与封装基板。 |
|
LG Innotek(LG伊诺特) |
韩国 |
LG集团旗下子公司,产品涵盖传感器、引线框架、封装基板等。 |
|
劲达科技股份有限公司(Jentech Precision Industrial Co.) |
中国台湾 |
台湾知名引线框架与精密模具制造企业,聚焦IC封装材料领域。 |
|
富晟电子(Fusheng Electronics) |
中国 |
提供封装用引线框架及相关冲压产品,服务于多个国内封装厂商。 |
|
华阳电子(HUAYANG ELECTRONIC) |
中国 |
中国本土的封装材料企业,产品应用于标准引线封装(如DIP、SOP、QFP等)。 |
|
永宏科技(Yonghong Technology) |
中国 |
国内新兴引线框架制造商,发展迅速,技术逐步向高密度封装领域扩展。 |
|
无锡麦克微精技术有限公司(WuXi Micro Just-Tech) |
中国无锡 |
聚焦高端IC封装引线框架,具有较强的研发能力和区域竞争力。 |
2.引线框架的切割与成形
在半导体封装中,引线框架不仅需要具备良好的导电性和热性能,其几何尺寸、图案精度和结构完整性也至关重要。因此,在制造过程中,必须采用高精度、高效率的切割与成形技术,以满足不断提升的封装微型化和复杂化需求。目前行业中广泛采用的两种核心技术为冲压(Stamping)与光化学蚀刻(Photochemical Etching),它们各有优势,适用于不同的产品需求和制造场景。
冲压工艺(Stamping):适用于批量大、结构相对简单的引线框架,工艺成熟、效率高、成本低。但对尺寸精度和复杂图形的控制有限。
光刻蚀工艺(Photo Etching):使用光刻+化学腐蚀技术,可加工出精细、高密度、复杂结构的框架,适用于高端精密器件。缺点是成本较高、产能相对较低。
在实际生产中,制造企业会根据不同产品要求、成本目标与产量需求,选择最合适的加工方式,部分高端封装还会融合冲压与蚀刻两种工艺以优化性能与成本。
2.1 引线框架冲压技术(Lead Frame Stamping)
冲压是一种传统且成熟的金属加工技术,适用于大规模、高速生产,是制造中低复杂度引线框架的主力工艺。其工艺流程包括金属带料输送、模具定位、冲头冲切与产品收集,整个过程可高度自动化,效率极高。
技术原理与流程:
将铜合金或其他金属带料通过模具,利用机械压力精确冲切出引线框架的所需图案和结构。模具通常由高强度钢制成,设计精度高,可实现多步复合冲压。
冲压的优点:
高产能与成本效率:适合连续卷带生产,可实现每分钟上百次冲压,显著降低单位成本。
尺寸一致性好:模具加工精度高,成品间公差控制在较小范围内,批量稳定性优异。
工艺成熟,维护简便:配套设备和模具技术成熟,适合大规模工业化应用。
典型应用:
适用于传统引线封装(如DIP、SOP、QFP)等对图案精度要求中等,但追求性价比和产量的封装形式。
2.2 引线框架光化学蚀刻技术(Lead Frame Photochemical Etching)
光化学蚀刻是一种先进的减材加工技术,适用于制造结构复杂、图案精细或对边缘质量要求极高的引线框架。该工艺不使用机械力,而是利用光刻与化学反应选择性去除材料,实现高精度图案转移。
技术原理与流程:
清洗与预处理:去除金属片表面的氧化层与杂质,保证后续涂层质量。
涂覆光致抗蚀剂:在金属表面涂上一层光敏材料。
掩膜对准与曝光:通过紫外光照射掩膜图案,使指定区域的抗蚀剂发生光化学反应。
显影:去除未曝光区域,留下图案。
蚀刻:用酸性或碱性蚀刻液溶解未被保护的金属区域,形成图案结构。
去膜与清洗:移除抗蚀剂,得到最终引线框架图形。
光化学蚀刻的优点:
图案复杂性高:适用于制造微米级线宽、高密度引脚、曲线形状等复杂结构。
边缘质量优异:切边平滑、无毛刺,提高封装电接触性能和焊接可靠性。
材料应力小:无机械变形,避免微结构翘曲或应力裂纹。
典型应用:
适用于BGA、QFN、LGA等小型化、薄型化封装形式,尤其适合高频、高速、高密度互联芯片的引线框架制造。
技术选择对比与发展趋势
|
项目 |
冲压(Stamping) |
光化学蚀刻(Etching) |
|
成本 |
较低(适合大批量) |
较高(适合中小批复杂产品) |
|
精度 |
中等(适合一般精度要求) |
极高(适合微型精密封装) |
|
可制造结构 |
规则、对称图案为主 |
任意复杂曲线、微结构 |
|
材料利用率 |
较高 |
略低,部分材料被蚀刻去除 |
|
模具依赖 |
高度依赖金属模具 |
依赖光掩膜与光刻精度 |
3.不同类型的引线框架
引线框架作为连接芯片与外部电路的关键部件,其类型随着封装技术的演进而日趋多样化。不同类型的引线框架适用于不同的封装方式、电气性能要求、热管理需求以及产品尺寸限制。以下是当前主流的引线框架类型及其特点和应用场景:
3.1 双列直插封装(DIP)引线框架
DIP(Dual In-Line Package)是最传统、最经典的一种引线框架形式,适用于通孔插装(Through-Hole Technology, THT)技术。
结构特点:两排平行引脚从塑封体两侧伸出,便于插入PCB通孔并进行波峰焊。
应用场景:广泛用于工业控制、早期计算机、电源模块等对连接可靠性要求较高、空间不太受限的电子产品中。
优点:机械强度高,维修方便,适用于手工焊接和测试验证阶段。
3.2 表面贴装封装(SMD)引线框架
SMD(Surface-Mount Device)引线框架适用于贴装工艺,是目前电子封装的主流趋势。
结构特点:引脚设计为“J型”或“S型”弯曲,从封装体侧边延伸出后贴合于PCB表面。
典型封装类型:SOIC、TSOP、TSSOP、SSOP等。

优点:体积小、重量轻、适合高密度布板,适用于自动化贴装与回流焊。
应用场景:消费电子、便携设备、通信模块等领域。
3.3 裸片直贴封装(COB)引线框架
COB(Chip on Board)是一种将裸芯片直接贴装于基板并用金线或铝线引出信号的封装方式,部分采用金属引线框架做为支撑或散热结构。
结构特点:无传统封装壳体,芯片直接贴在基板或引线框架上,通过点胶或封胶进行保护。
优点:封装体积极小,散热性能优异,导线长度短,有利于高速信号传输。
应用场景:LED照明、传感器模块、摄像头模组等对散热和紧凑性要求高的产品。
3.4 无引脚四方扁平封装(QFN)引线框架
QFN(Quad Flat No-lead)是一种紧凑型无引脚封装,广泛用于对封装厚度、散热及电气性能有较高要求的场景。
结构特点:封装四周无引脚,引线嵌入于封装底部边缘,通过底部金属焊盘进行连接;部分QFN封装带有中间大面积散热焊盘。
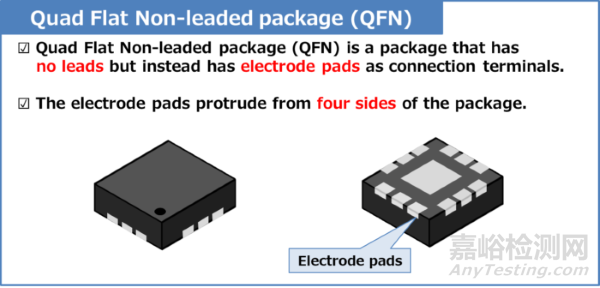
优点:优异的散热性能和电气性能,低寄生电感、体积小、封装厚度薄。
应用场景:移动终端、高速通信芯片、射频芯片、汽车电子控制器等。
3.5 球栅阵列封装(BGA)引线框架
BGA(Ball Grid Array)通过在封装底部阵列排列的锡球代替传统引脚,提升了引线密度与可靠性。
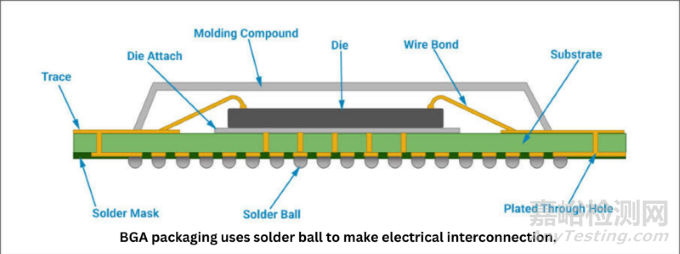
结构特点:无传统引线,封装底部阵列分布焊球,与PCB焊盘一一对接。
优点:电气性能好,封装密度高,散热效果佳;适合高引脚数、高频率应用。
应用场景:高性能CPU、GPU、存储芯片、网络处理器及电源管理芯片等。
3.6 小外形晶体管封装(SOT)引线框架
SOT(Small Outline Transistor)系列封装广泛应用于小型分立器件的封装。
结构特点:体积小巧,引脚从封装体一侧或两侧引出,通常为三引脚或五引脚设计。
典型类型:SOT-23、SOT-223、SOT-89等。
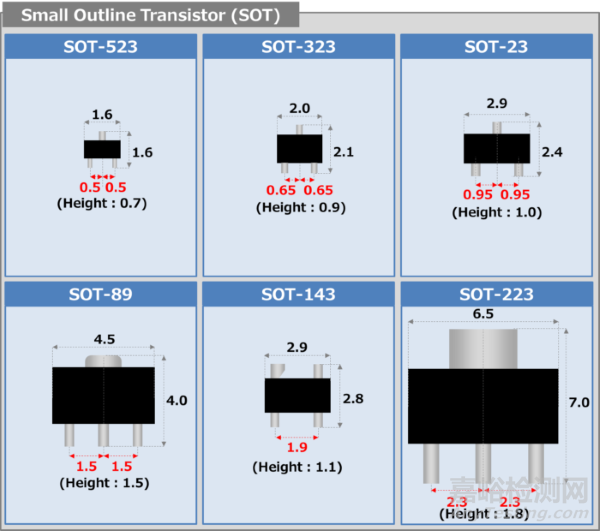
优点:装配灵活,适合自动化贴装,适用于中小功率场合。
应用场景:信号放大、开关控制、功率管理等小型器件。
3.7 小外形集成电路封装(SOIC)引线框架
SOIC(Small Outline Integrated Circuit)是一种SMD结构的中小型集成电路封装形式。

结构特点:与DIP结构类似,但封装更薄、引脚间距更小,引脚从侧面弯曲贴合PCB。
优点:相较DIP,SOIC封装节省空间,支持表面贴装工艺。
应用场景:音频放大器、逻辑电路、MCU等中低引脚数芯片。
3.8 平封装(Flatpack)引线框架
Flatpack是一种主要用于军工、航天、工业高可靠性场合的引线框架类型。

结构特点:封装形状扁平,金属壳体密封,侧边或底部引线引出,适用于恶劣环境。
优点:耐高温、高湿、高震动,机械强度高,具备良好的气密性。
应用场景:军用电子器件、卫星通信、航空航天设备等。
引线框架的多样化源于电子器件封装在性能、尺寸、成本及环境适应性方面的多元需求。从传统的DIP、SOIC,到高性能的QFN、BGA,再到针对特种应用的COB、Flatpack,各类引线框架在不同封装技术中扮演着至关重要的角色。随着半导体封装朝着更高密度、更小尺寸和更好散热性能发展,引线框架的设计与制造也正不断进化,以满足未来电子产品的需求。
参 考:
1.Stamped & High Precision Lead Frames | Wiegel
2.Leadframes - ROHM MECHATECH CO., LTD. Official site
3.Progressive Die High Speed Stamping - High Volume Stamping | Wiegel
4.Precision Metal Etching Lead Frames Parts_Precision Etched Parts
5.Leadframe Market Report: Trends, Forecast and Competitive Analysis
6.What is a Surface Mount Device or SMD Component Package? - JHYPCB
7.Definition of chip on board | PCMag
8.What is Quad Flat Non-leaded package (QFN)? - Electrical Information
9.A Guide to Ball Grid Array (BGA) Packages
10.SOIC Packages: Design & Soldering Guide | Reversepcb
11.Flatpack (electronics) - Wikipedia
12.https://www.worthyhardware.com/news/lead-frames/
13.Understanding Leadframe vs Substrate: Roles in Packaging
14.What is a semiconductor package substrate? | TOPPAN Electronics Division

来源:芯片技术与工艺
关键词: 半导体